
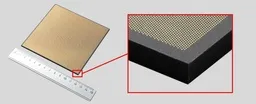
京セラが開発中の多層セラミックコア基板:次世代半導体パッケージへの挑戦
京セラが挑む次世代半導体パッケージの進化
京都に本社を置く京セラ株式会社が、多層セラミックコア基板の商用化に向けた新たな開発を進めています。急速に進化するAIデータセンター向けの先端半導体パッケージに対応するこの製品は、特に大型化が進むxPUやスイッチASIC向けでの利用が期待されています。2026年にアメリカ・オーランドで開催される国際学会「ECTC2026」で、この革新的な基板が初めてお披露目される予定です。
開発の背景
近年、生成AIや大規模言語モデル(LLM)の普及により、データセンターの新設や拡張が世界各地で進展しています。これにより、先端半導体の需要も急増しており、高速・大容量通信を担うxPUやスイッチASICの高性能化が進んでいます。特に、2.5Dパッケージ型として知られるパッケージ基板の大型化と高密度配線化が加速しているため、これに応える新たな技術が求められています。
しかし、大型化する有機コア基板では、剛性不足に起因する反りや配線の微細化が課題として顕在化しています。こうした問題を解決するために、京セラはこれまで培った材料とコア技術を駆使し、高剛性と微細配線を両立させた多層セラミックコア基板の開発に取り組んでいます。
製品の特徴
この多層セラミックコア基板の主な特徴は三つあります。
1. 高剛性による反りの低減
この基板は、従来の有機コア基板よりも高剛性を持ち、曲げ強度が高いため、実装プロセスでの反りを最小限に抑えることができます。また、薄型化にも寄与します。
2. 微細加工性の向上
セラミック材料を焼成する前の柔らかい状態でビア形成を行うことで、より細かい配線を可能にします。これにより、有機コア基板では難しかった高密度配線化が実現できます。
3. シミュレーションとカスタム設計のサポート
京セラは、顧客のデバイス仕様や実装条件に基づいた熱応力シミュレーションや基板反りシミュレーションを行い、開発効率を向上させるカスタム設計を提案しています。
今後の展望
京セラは、この多層セラミックコア基板の開発を通じて、半導体関連産業の発展に貢献することを目指しています。さまざまなニーズに応じた材料や実装技術の開発を継続し、より効率的かつ高性能な半導体パッケージの提供を目指す姿勢を貫いていくことでしょう。データセンターの未来を支えるこの基板が、どのように業界に影響を与えていくのか、今後の展開が楽しみです。
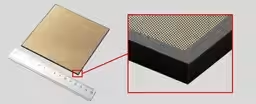

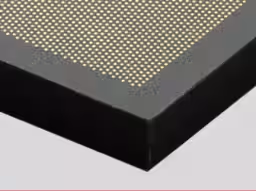

トピックス(その他)










【記事の利用について】
タイトルと記事文章は、記事のあるページにリンクを張っていただければ、無料で利用できます。
※画像は、利用できませんのでご注意ください。
【リンクついて】
リンクフリーです。